【IEDM 2007レポート】
次世代不揮発性メモリもマルチレベルを指向
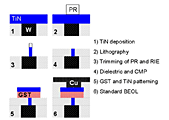 |
| 相変化型メモリ(phase change memory)の記憶素子を製造する工程。図中にGSTとあるのがカルコゲナイドのGeSbTe合金で、結晶状態とアモルファス状態を行き来する。GSTの上下は電流を加えるための電極。この写真はIEDM 2007の論文資料から抜粋した |
会期:12月10~12日(現地時間)
会場:米国ワシントンD.C.
Hilton Washington and Towers
半導体メモリでは1個のメモリセルに通常、2個の値を記憶する。論理レベルの高レベルあるいは低レベル、データ値の1あるいは0に相当する。言い換えると、1個のメモリセルに1bitのデータを記憶していることになる。
マルチレベルとは、1個のメモリセルに3個以上のレベルを記憶させることを意味する。例えば4個のレベルを記憶させれば、1個のメモリセルに2bitのデータを蓄えることになる。当然ながら1bitを記憶するときに比べるとメモリセル当たりの記憶容量が2倍に増える。結果としてメモリチップ全体でも記憶容量が2倍に増大する。
マルチレベルの記憶方式は、NANDフラッシュメモリで製品に使われ始めた。現在、NANDフラッシュメモリの大容量品では1個のメモリセルに2bitを記憶する方式が主流になっている。今後は、1個のメモリセルに3bitあるいは4bitを記憶するNANDフラッシュメモリも市販されると期待される。
NANDフラッシュメモリの次を狙う次世代不揮発性メモリでも、マルチレベルを狙った研究開発が始まっている。IEDM 2007では、その一部が公表された。
●相変化型メモリの記憶素子1個に4bitを書き込む
IBMとQimonda、Macronix Internationalは、相変化型メモリ(phase change memory)の共同研究プロジェクト「PCRAM Joint Project」を進めている。研究プロジェクトの一環としてマルチレベル記憶方式を手掛けており、その成果をIEDM 2007で披露した(講演番号17.5)。
相変化型メモリとは、カルコゲナイドと呼ばれる合金材料が結晶状態と非晶質状態(アモルファス状態)の2つの状態を行き来する(相変化する)性質を利用したメモリである。合金材料に電流を加えることで相変化を起こす。結晶状態では電気抵抗が低く、アモルファス状態では電気抵抗が高い。電気抵抗率換算では、両者の違いは3桁~5桁にもなる。この違いを論理レベルの高レベル、あるいは低レベルに対応させることで、1bitのデータを読み書きする。これは不揮発性メモリであり、書き込み時間がフラッシュメモリに比べて短いという特長がある。
抵抗率の違いが3桁~5桁にもおよぶということは、書き込み電流と書き込み時間を精密に制御することで、その中間の抵抗値を作り出せることを意味する。中間の抵抗値レベルを2個作れば、全体のレベルは4個になり、2bitを記憶できることになる。IBMとQimonda、Macronix Internationalの共同研究グループは実際に中間の抵抗値レベルを書き込み、最大で16値、すなわち1個のメモリセルに4bitのデータを書き込めることを示した。
具体的には10個×10個の記憶素子アレイを試作し、16段階の抵抗値を書き込んでみせた。書き込み電流と書き込み時間を精密に制御することで、抵抗値のばらつきを非常に狭い範囲に抑え込んだ。
また16Kbitのメモリを試作し、4段階の抵抗値を書き込んでみせた。1個の記憶素子に2bitのデータを書き込んでいるので、実際には32Kbitのメモリとして利用できる。物理的には16Kbitメモリだが、論理的には32Kbitメモリということになる。
 |
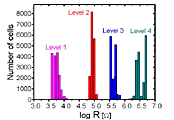 |
| 10個×10個の記憶素子アレイに16個の抵抗値レベルを書き込んだところ。この写真はIEDM 2007の論文資料から抜粋した | 16Kbitのメモリ(記憶素子アレイ)に4個の抵抗値レベルを書き込んだところ。この写真はIEDM 2007の論文資料から抜粋した |
●ReRAMでもマルチレベルを実現
続いて紹介するのはソニーの研究成果である。ソニーは次世代不揮発性メモリの候補であるReRAM(Resistive RAM)を開発中で、その開発成果の一部をIEDM 2007で公表した(講演番号30.5)。
ReRAMとは抵抗変化型メモリとも呼ばれ、電圧を加えることによって電気抵抗が変化する材料を記憶素子に使った不揮発性メモリであり、研究開発が活発に行なわれている。電気抵抗が変化するメモリと書くと、相変化型メモリと何が違うのかと言われそうだが、電気抵抗の違いをデータの記憶に利用する点では両者に違いはない。
違うのは物理的な現象と歴史的な背景である。カルコゲナイド合金を使った相変化型メモリは、前半で述べたように「相変化」によって電気抵抗を変化させる。しかしReRAMは相変化は使わず、別の原理によって電気抵抗を変える。
そして相変化型メモリは光ディスクや光カードなど、半導体メモリ以外にも応用研究の長い歴史がある。しかしReRAMは最近になって研究開発が活発化した半導体不揮発性メモリであり、物理的な現象についてもいくつもの方式がある。しかも研究の歴史が浅く、電気抵抗が変化する機構の詳細はあまり解明されていない。原理が違うものに対してひとくくりに“ReRAM”と呼んでしまうのは厳密さを欠くのだが、便宜上、ReRAMやResistance Memoryといった名前で呼ばれている。
ソニーのReRAMは、電圧印加によって金属イオンを酸化膜中に移動させ、酸化膜の電気抵抗を変化させる方式を採用した。ReRAMではこのほかに酸化物に電圧を加えて電気抵抗を変化させる方式があり、複数の半導体メーカーが研究を進められている。ソニーは酸化物を利用する方式に比べて金属イオンを動かす方式はデータの書き込みに必要なエネルギが小さく、高速動作の点で有利だと主張する。
ReRAMでは電気抵抗の高い状態をリセット、電気抵抗の低い状態をセットと呼ぶ。基本状態は電気抵抗が高い状態で、電圧を加えることで電気抵抗の低い状態を作り出す。ソニーが示したデータによると、リセットとセットの2値では、電気抵抗の違いは3桁~4桁になる。これだけの違いがあれば、相変化型メモリと同様に、マルチレベルを実現できそうだ。
ソニーはセット時の電気抵抗を3つのレベルに制御することで、1個の記憶素子に合計4つの抵抗値レベルを書き込んでみせた。セットとリセットに必要な電圧パルスの幅は10nsで、フラッシュメモリに比べると非常に短い時間でデータを書き込めている。
相変化型メモリとReRAMはいずれも研究段階のメモリであり、マルチレベルはもちろんのこと、1つのメモリセルに1bitを記憶する基本的な方式でも実用化にはまだまだ距離がある。研究開発の今後の進展に期待したい。
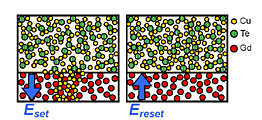 |
| ソニーが開発中のReRAMの原理。金属CuイオンがGd酸化膜層(本来は絶縁物)に移動することでGd酸化膜層の電気抵抗が下がる。この図面はIEDM 2007の論文資料から抜粋した |
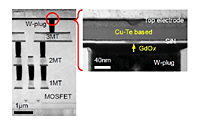 |
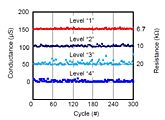 |
| 試作したメモリセルアレイの断面を透過型電子顕微鏡で観察した像。4kbit(64×64bit)のメモリセルアレイを180nmのCMOS技術で試作した。この写真はIEDM 2007の論文資料から抜粋した | 4個の抵抗値レベルを書き込むサイクルを繰り返した様子。この図面はIEDM 2007の論文資料から抜粋した |
□IEDM 2007のホームページ(英文)
http://www.his.com/~iedm/
□関連記事
【12月10日】IEDM 2007前日レポート、次世代不揮発性メモリの本命争いが激化
http://pc.watch.impress.co.jp/docs/2007/1210/iedm01.htm
【11月20日】【MemCon】「DRAMとPC」から「NANDフラッシュと民生/家電」へ
http://pc.watch.impress.co.jp/docs/2007/1120/mct.htm
(2007年12月14日)
[Reported by 福田昭]
【PC Watchホームページ】
PC Watch編集部 pc-watch-info@impress.co.jp お問い合わせに対して、個別にご回答はいたしません。
Copyright (c)2007 Impress Watch Corporation, an Impress Group company. All rights reserved.
