Intel、45nmプロセスの次期CPU「Penryn」の試作に成功
~High-k+金属ゲートを初採用
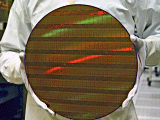 |
| Penrynのウェハ |
1月26日(現地時間)発表
米Intelは26日(現地時間)、45nmプロセスを採用する次期プロセッサ「Penryn(ペンリン)」(コードネーム)の試作に成功したと発表した。
Penrynは、現行のCore 2シリーズ(コードネーム:Conroe/Merom)の後継となるプロセッサ。Core 2シリーズと同じCoreマイクロアーキテクチャをベースに、キャッシュ容量の増大(最大12MB)や、新命令セット「SSE4」の実装といった改良が図られている。
45nmプロセスを採用するプロセッサはPenrynが初だが、トランジスタの製造において、プロセスルールのシュリンク以外にも、High-k(高誘電率)ゲート絶縁膜採用という抜本的な改革がなされている。
これまで過去40年間、ゲート絶縁膜の材料には二酸化シリコン(SiO2)が用いられてきた。しかし、65nm世代ではゲート絶縁膜の厚みが1.2nmにまで薄くなり、ゲート絶縁膜を通り抜けるリーク電流が増大し、大きな問題となっていた。
そこで同社は、ゲート絶縁膜に、厚みのあるハフニウム系High-k材料を採用。これにより、ゲート絶縁膜のリーク電流を1/10以下に削減した。
また、High-kゲート絶縁膜は、現在のポリシリコンゲートではうまく動作しないため、新たに異なった金属を組み合わせた複合材料を採用した。同社によれば、High-kゲート絶縁膜と金属ゲートの組み合わせにより、トランジスタのスイッチング速度は約20%向上し、同等性能であれば、ソースドレインのリーク電流を5倍以上抑えられるという。なお、金属の材料名は明かされていない。
Penrynの製造は、2007年後半から45nm/300mmウェハ対応のD1D(米国オレゴン)、Fab 32(米国アリゾナ)で開始され、2008年からはFab 28(イスラエル)にも展開する。
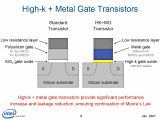 |
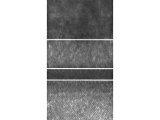 |
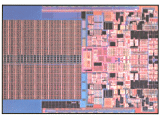 |
| トランジスタの模式図 | 45nm High-K+金属ゲートの写真。下からシリコン基板、High-kゲート絶縁膜、金属ゲート、低抵抗層 | Penrynのダイ。デュアルコアなのが分かる |
□Intelのホームページ(英文)
http://www.intel.com/
□ニュースリリース(英文)
http://www.intel.com/pressroom/archive/releases/20070128comp.htm
□ニュースリリース(和文)
http://www.intel.co.jp/jp/intel/pr/press2007/070129.htm
□関連記事
【2006年1月26日】Intel、45nmプロセスの153Mbit SRAMの製造に成功
http://pc.watch.impress.co.jp/docs/2006/0126/intel.htm
【2005年12月2日】Intel、イスラエルに45nmプロセスのFab 28を建設
http://pc.watch.impress.co.jp/docs/2005/1202/intel.htm
【2005年7月26日】Intel、アリゾナ州に45nmプロセス向け300mmウェハ工場を建設
http://pc.watch.impress.co.jp/docs/2005/0726/intel2.htm
【2003年11月5日】インテル、45nmプロセスに向けたリーケージ削減技術などを発表
http://pc.watch.impress.co.jp/docs/2003/1105/intel.htm
(2007年1月29日)
[Reported by wakasugi@impress.co.jp]
【PC Watchホームページ】
PC Watch編集部 pc-watch-info@impress.co.jp お問い合わせに対して、個別にご回答はいたしません。
Copyright (c)2007 Impress Watch Corporation, an Impress Group company. All rights reserved.
