PHM 2008レポート
はんだ付けの寿命とコンデンサの故障時期を予測
 |
| ポスターセッションの会場風景 |
会期:10月6日~10月9日(現地時間)
会場:米国コロラド州デンバー市 Marriott Tech Center
PHM技術が目指すのは、システムやデバイスなどの故障予測と故障診断である。システムとデバイスでは、より複雑な要素が絡みあう、システム・レベルのPHM技術が圧倒的に難しい。「PHM 2008」では残念ながら、エレクトロニクス・システムの故障時期を予測した研究発表は登場しなかった。まだ時期尚早ということなのだろう。
これに対して、デバイス・レベルの故障予測はいくつかの研究発表があった。デバイス・レベルでの予測が簡単という訳ではないものの、故障メカニズムがかなり明らかになっているため、システム・レベルに比べると研究が進んでいる。本レポートでは、デバイス・レベルで寿命を予測した発表事例をいくつか紹介しよう。
●鉛フリーはんだ付けの不良
最初に報告するのは、鉛フリーはんだを使ったはんた付けの故障予測である。米Auburn大学の研究成果だ(P. Lallほか、講演タイトル:Latent Damage Assesment and Prognostication of Residual Life in Airbone Lead-free Electronics Under Thermo-Mechanical Loads)。
組成の異なる6種類の鉛フリーはんだ合金を使い、プリント基板にBGAパッケージをはんだ付けした接続部の寿命を評価した。はんだ付け接続部へのストレスとしては、温度サイクル(低温環境と高温環境に繰り返し曝す)を使用した。低温(-40℃)と高温(+125℃)の繰り返しによって接続部が伸縮し、機械的な応力が加わる。このため、はんだ内部に異物に相当する結晶が成長し。接続部の電気抵抗が上昇する。
観察結果と故障予測モデルから、はんだ接続部の1%が接続不良となるまでの時間を寿命として計算した。5点のサンプルで予測寿命と実際の寿命を比較したところ、4点は実際の寿命よりも予測値が短くなり、1点は実際の寿命よりも予測値が長くなった。予測と実際にはかなりのずれがあり、改良の余地がまだ大きいことが分かる。
 |
 |
| テスト・ボードの概要 | 実験に使用した鉛フリーはんだ合金とBGAパッケージの一覧 |
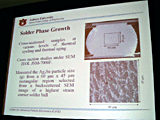 |
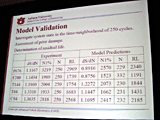 |
| はんだ内部に結晶(異物に相当する)が成長した様子 | 予測した寿命(表中右端のRL)と実際の寿命(表中の中央部のRL)。左端はサンプルのラベル名。例えばP676番のサンプルでは、予測寿命が2,340時間、実際の寿命が2,969時間となった |
●高周波測定ではんだ付け劣化を早期に検出
はんだ付け接続部の不良を検出する最も手っ取り早い方法は、電気抵抗を測定することである。通常は直流抵抗を測定する。ただし、はんだ接続部の劣化が進んでオープン不良に近い状態になってから、直流抵抗には変化が生じることが多い。すなわち直流抵抗測定では、不良の兆候を検出する手段とはなりにくい。
そこで直流抵抗ではなく、高周波インピーダンスを測定することで、はんだ付け接続部の不良の兆候を検出する試みを米国Maryland大学のCALCE(Center for Advanced Life Cycle Engineering)が発表した(D. Kwonほか、講演タイトル:Early Detection of Interconnect Degradation Using RF Impredance and SPRT)。高周波電流は表皮効果によってはんだの表面近くに集中するため、クラックなどの劣化に敏感になると考えた。
実験では表面実装型のチップフィルタをプリント基板にはんだ付けし、機械的なストレスを繰り返し与えた。直流抵抗測定と高周波インピーダンス測定(TDR測定を利用)ではんた付け接続部の抵抗をモニタリングした。
実験の結果、直流測定では1,303分後にオープン不良が発生した。これに対して高周波測定では1,109分後に、不良の兆候とみられるインピーダンスの上昇が発生した。オープン不良が発生する194分前に、不良の兆候を検出したことになる。
11回のテストではすべて、直流抵抗測定でオープン不良となる前に、高周波測定で不良の兆候を検出できた。ただし検出できたタイミングは2分前(寿命の1%に相当する時間)~363分前(寿命の38%に相当する時間)とかなりのばらつきがある。ばらつきを何らかの手段で狭めるか、精度の高い寿命予測モデルを構築する必要があるだろう。
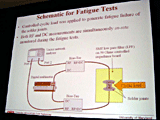 |
 |
| はんだ付け接続部を劣化させる実験のセットアップ | 劣化させる実験の試験条件。40N(ニュートン)と10Nの応力をはんだ付け接続部に繰り返し(周波数0.25Hz)与える |
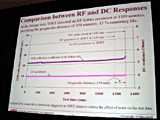 |
 |
| 直流測定と高周波測定の結果。高周波測定ではオープン不良が発生する194分前に、不良の兆候を捉えることができた | 11回のテスト結果のまとめ。高周波測定ではすべて、オープン不良の発生前に兆候をとらえることができた |
●積層セラミックコンデンサの寿命を高い精度で予測
コンデンサは、ごく普通にみかける電子部品である。なかでも積層セラミックコンデンサはチップ型という取り扱いの容易さと小さく軽いことから、最も普及しているコンデンサといえよう。
積層セラミックコンデンサの代表的な故障モードに、絶縁不良がある。クラックや電極剥離などによって絶縁抵抗が下がってしまう不良モードだ。この絶縁不良に至るまでの時間を予測する技術を、米国Maryland大学のCALCEが開発した(J. Guほか、講演タイトル:Failure Prognostics of Multilayer Ceramic Capacitors in Temperature-Humidity-Bias Conditions)。
実験では、最初に温度サイクルによる負荷をコンデンサに与えたあと、高温高湿バイアス試験によって故障するまでの時間を測定した。試験時間は1,240時間で、3時間ごとに絶縁抵抗と静電容量、誘電正接を測定した。1,240時間を超えても故障しなかったサンプルは、試験をその時点で中止した。
実験では、10個のサンプルの中で5個が絶縁不良を起こし、残りの5個が生き延びた。不良を発生したサンプルと生き延びたサンプルの絶縁抵抗値と誘電正接値から寿命予測のモデルを構築し、不良が発生するまでの時間を推定した。例えば3番のサンプルでは、不良の兆候が発生した時刻が720時間後、推定寿命が806時間であったのに対し、実際の寿命は853時間と比較的良く一致した。
そのほかのサンプルにもモデルを当てはめて寿命を推定したところ、高い精度で推定寿命と実際の寿命が一致した。CALCEはコンデンサの不良解析で豊富な実績を有している(CALCEに持ち込まれる電子部品の不良解析依頼の中で、30%がコンデンサである)ことから、きわめて優れた予測モデルを構築していると考えられる。
不良モードが絶縁不良に限定されるといった条件はあるものの、ここまで高い精度が出せるのは驚異的とすら言える。それぐらい、寿命の予測は難しい。ここまでの精度が出せるのであれば、PHM技術の将来は非常に明るいと言えよう。
 |
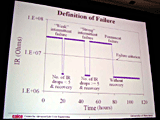 |
 |
| 積層セラミックコンデンサの試験条件 | 絶縁不良の定義。抵抗値が10メガオームを切った場合を不良と定義した。コンデンサの中には一時的に絶縁抵抗が下がってから回復するケースがあるので、一時的な不良は「intermittent failure」と呼んで永久的な不良「permanent failure」と区別した | 絶縁不良を起こしたサンプルと、不良発生までの時間(故障発生までの寿命) |
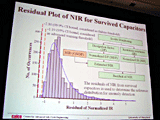 |
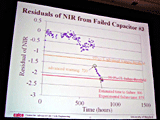 |
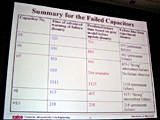 |
| 生き残ったサンプルの絶縁抵抗を正規化し、寿命推定のモデルを作る | 3番のサンプルにおける絶縁抵抗の変化と推定寿命 | 絶縁不良を起こしたサンプルの寿命を推定した結果。左の青い数字が、絶縁不良の兆候が現れた時間。中央の赤い数字が推定寿命。右の黒い数字が実際の寿命である。赤い数字と黒い数字(推定値と実際の値)が非常に良く一致している |
□PHM 2008のホームページ(英文)
http://www.phmconf.org/
□関連記事
【10月8日】【PHM 2008】愛犬がノートPCに粗相をしても慌てずに済む技術を目指す
http://pc.watch.impress.co.jp/docs/2008/1008/phm01.htm
【10月6日】故障を事前に察知する研究の国際会議「PHM 2008」前日レポート
http://pc.watch.impress.co.jp/docs/2008/1006/phm00.htm
(2008年10月9日)
[Reported by 福田昭]
【PC Watchホームページ】
PC Watch編集部 pc-watch-info@impress.co.jp お問い合わせに対して、個別にご回答はいたしません。
Copyright (c)2008 Impress Watch Corporation, an Impress Group company. All rights reserved.
