【IDF 2007基調講演レポート】
マーク・ボーア氏基調講演
~プロセスは45nm、そして次世代へ
 |
| Intelの製造プロセスについて解説するMark Bohr上級フェロー |
会期:4月17日~18日(中国時間)
会場:Beijing International Convention Center
今回のIDFは、2日間しかなく、基調講演も午前中だけなので、枠としてはかなり限られている。その中で、2日目には、Intel上級フェローのMark Bohr(マーク・ボーア)氏による、プロセス技術関連のスピーチが行なわれた。
●IntelのシリコンR&Dパイプライン
ボーア氏によれば、Intelのシリコン関連の研究開発は、パイプライン化されているという。つまり、研究、開発、製造の3ステージがあり、現世代のデバイスの製造、同時に次世代プロセスの開発、2世代先の研究が同時に止まることなく動いているということだ。
現在では、65nmの製造が行なわれ、開発は45nmを完了しつつあり、研究は32、22nmを実現すべく動いている。この体制はIntelが続く限り決して途切れることはない。
今回のIDFの基調講演は、中国向けなのか、技術的にはやさしいレベルから始まる。ボーア氏のスピーチは、技術的には高度なものの、すでに過去の製造プロセスである130nmあたりからの発展をなぞる形で進められた。
Intelは、130nmプロセス以降、90、65nmとプロセスを進化させ、2007年後半に登場するPenrynとSilverthorneが45nmで製造される。
ボーア氏は、すでに実用化されている130~65nmに関して、トランジスタや配線技術などを紹介していった。いつもそうだが、同氏の話す感じは淡々としていてまるで学校の授業を聞くようである。
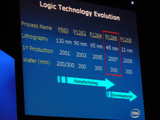 |
 |
| これまでのIntelの製造プロセス。現在は、45nm開発の最終段階にあり、次世代である32nmの開発も始まっている | 45nmで採用された高誘電率ゲート絶縁膜メタルゲートトランジスタ(High-k)と従来のトランジスタの比較。ゲート部分が金属となり、絶縁膜に高誘電率材料が使われている |
 |
 |
| 45nmプロセスで最初に製造されるのは、次世代プロセッサであるPenrynと、UMPC向けのLPIAプロセッサであるSilverthorneである | 45nmプロセスのデバイスは、オレゴン(D1D)、アリゾナ(Fab32)、イスラエル(Fab28)、ニューメキシコ(Fab 11X)の4カ所で製造される |
次に、2007年後半に製品が登場する45nmについての話に入る。実は45nmでは、トランジスタや配線技術が大きく変わる。つまり、単に前世代よりも細かく作るというだけでなく、正しく動作させるために、さまざまな工夫が必要になったわけだ。それは、トランジスタ自体のサイズが小さくなったのに対して、構造や物質に起因する現象自体は変化しないため、サイズが大きいときには問題にならなかった現象が大きく影響したり、あるいは現象の効果が小さくなってしまうからだ。
たとえば、トランジスタは、これまでのものと違って、ゲート部分に金属(メタル)材料を使う「メタルゲート・トランジスタ」を採用する。ゲートを金属にすることで、ソースとドレイン間に起こる電界効果を強くすることができる。なお、半導体にはp型とn型があるが、メタルゲートトランジスタでは、p型とn型で金属材料には違うものを使う。
ただ、ゲート部分をメタルにするのではなく、ソースやドレインとの間にハフニウム(原子番号72の物質)を使った酸化膜(絶縁膜)を設ける。
この絶縁膜は誘電率が高く、このようなものををHigh-k(kは誘電率を表す記号)材料という。つまり、45nmプロセスのトランジスタは、「高誘電率ゲート絶縁膜 メタルゲートトランジスタ」になるわけだ。
この2つの組み合せでトランジスタの駆動電流(動作させるのに必要な電流)は20%下がり、ソースとドレイン間のリーク電流を従来の5倍以上抑えることが可能になった。
●32nm以後も新技術を導入
さらに話は、次世代、つまり、2009年に登場予定の32nmプロセスに移る。32nmでは、さらにさまざまな工夫が必要になる。
半導体は、簡単にいうと写真のように作る。ところが、現在使われている露光装置が使う波長は193nmで、作成される半導体のゲート長やプロセスルールよりも長くなってしまっているため、正確に露光することが難しくなってきた。
このためにいくつかの技術が使われる、それがOPC(Optical Proximity Correction)などである。OPCは、マスクの穴の部分に露光が正確に行なわれるように補正用のパターンを作る。たとえば角が四角いのに丸く露光されてしまうような場合、角の部分を深く切り込んでおき、希望のパターンが得られるようにあらかじめ修正しておくわけだ。
このほかにレンズの開口数(NA:Numerical Aperture)を上げる、光の位相を利用する、レンズと露光対象の間に液体を満たして屈折率を変える(Immersion Lithography)といった技術が使われ、どうにか32nmでも従来の露光装置が使えるようになっている。
しかし、その先にいくためには、もっと短い波長の光を使う必要があり、そのために考えられているのが波長13nmのEUV(極紫外線)を使う方法である。このEUV露光装置については、以前のIDFで紹介されたこともある。
このほか、トライゲートトランジスタやInSb(アンチモン化インジウム)量子井戸(Quantum Well)を使ったトランジスタなども開発が行なわれているという。
トライゲートトランジスタは、すでにIntelが発表を行なっているが、これは、ソースとドレインを構成する部分を立体的に作る。それは煉瓦など直方体を平らなところに置いたような形である。置かれた直方体に直角に交わるように一回り大きな直方体を作り、ソース/ドレイン部分の上と左右を囲んでトランジスタを構成する。
InSb量子井戸トランジスタは、電子やホールの移動速度を高める技術。InSbで薄い膜を作り量子井戸効果を起こすと、電子やホールがこの膜の間に閉じこめられ、上下方向に動くことができなくなる。また、InSbの特性から電子の移動速度が速く、より少ないエネルギーで高速に動作できるようになる。
CPUの製造技術は、Intelとしては本業であるものの、開発者から見れば、必ずしも必要な情報ではない。製造プロセスを知らなくても、ハードウェアやソフトウェアの開発は可能だからである。
それでもこうした枠を設けるのは、1つには、Intelの技術的な優位性を示すためであり、おそらくもう1つは、優秀な人材を集めるためであろう。
□IDF 2007のホームページ(英文)
http://www.intel.com/idf/
□関連記事
【4月18日】【元麻布】着々と進む45nmプロセスとクアッドコアへの道
http://pc.watch.impress.co.jp/docs/2007/0418/hot478.htm
【1月29日】Intel、45nmプロセスの次期CPU「Penryn」の試作に成功
http://pc.watch.impress.co.jp/docs/2007/0129/intel.htm
(2007年4月19日)
[Reported by 塩田紳二]
【PC Watchホームページ】
PC Watch編集部 pc-watch-info@impress.co.jp お問い合わせに対して、個別にご回答はいたしません。
Copyright (c)2007 Impress Watch Corporation, an Impress Group company. All rights reserved.