IEDM 2007レポート
IEDM実行委員会が選ぶ注目講演、
High-k/Metal-gate FETやNVRAMなどを列挙
 |
| 「2007 IEDM Press Luncheon」の名称で報道機関向けの昼食会が開催された |
会期:12月10日~12日(現地時間)
会場:米国ワシントンD.C.
Hilton Washington and Towers
半導体デバイス技術に関する世界最大の国際学会IEDM(International Electron Devices Meeting)」が始まった。初日の12月10日は、正午に報道機関向けの昼食会(プレスランチョン)がIEDM実行委員会によって開催され、IEDM 2007のハイライトが紹介された。
 |
| IEDM2007の実行委員会でPublicity Chairを務めるMeikei Ieong氏(台湾TSMC)が、見どころ(ハイライト)を説明した |
ハイライトの紹介役を務めたPublicity ChairのMeikei Ieong氏(台湾TSMC)は最初に、CMOSデバイスの性能が何よって決まるかを説明した。3つの決定要因があり、1つがスケーリング(微細化)、もう1つがキャリアの移動度、最後がリーク電流の制御だと述べていた。
微細化のトレンドでは、45nm CMOSデバイスの量産が2007年後半~2008年後半にかけて始まり、32nm CMOSデバイスの量産が2009年後半~2010年後半に始まるとの見通しを示した。そして注目講演として、45nmのCMOS技術の詳細をIntelが初めて公表すること、32nmのCMOS技術をTSMCが発表することを挙げていた。
キャリアの移動度に関しては歪みシリコン技術の改良や、シリコン基板の方位を(110)に変更すること、新材料の導入といった要素技術の開発で移動度を高めていく。特に、FETに高誘電率のゲート絶縁膜と金属ゲート電極を導入するときに、どのような材料を選び、製造の手順をどのように構築するかに注目が集まっている。本命の手法がまだ決まっていないからだ。
 |
| 半導体先端テクノロジーズ(Selete)による講演(講演番号20.3)中、FETの断面構造模式図。この図面は、IEDM実行委員会がプレス向けに配布した資料の一部 |
 |
| 半導体先端テクノロジーズ(Selete)による講演(講演番号20.3)で、試作したFETの断面をTEM(透過型電子顕微鏡)で観察した像。この図面は、IEDM実行委員会がプレス向けに配布した資料の一部 |
CMOSデバイス技術以外のハイライトでは、メモリ関連の講演が非常に多いことがある。6本ものセッションでメモリ技術の講演が予定されている。DRAM、NANDフラッシュメモリ、MRAM、相変化型メモリ、ReRAM、ヒューズ方式メモリとさまざまなメモリ技術が並ぶ。なかでも不揮発性メモリ(NVRAM)に関する講演が多い。
化合物半導体では、半導体デバイスの極限を追求した高周波トランジスタと高耐圧トランジスタの講演をハイライトに挙げていた。Intelがシリコン基板に化合物半導体を積層するデバイスを発表することにも注目したい。このほか、新しい概念に基づくデバイスの講演をいくつか、ハイライトに列挙していた。
 |
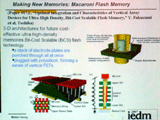 |
| メモリ関連の講演があるセッションの一覧 | メモリ関連の注目講演の例。東芝の次世代NANDフラッシュメモリセル(講演番号17.2)。トランジスタを縦方向に積層することでNAND型のメモリセルアレイ(セルストリング)を構成する。極めて高密度なフラッシュメモリを実現できる |
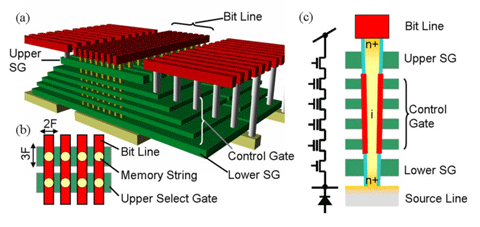 |
| 東芝の次世代NANDフラッシュメモリセル(講演番号17.2)の構造模式図。(a)はセルアレイ全体の鳥瞰図。(b)はセルアレイの上面図。(c)はセルストリングの断面図。セルトランジスタはSONOSタイプ。なおこれらの図面は、IEDM実行委員会がプレス向けに配布した資料の一部 |
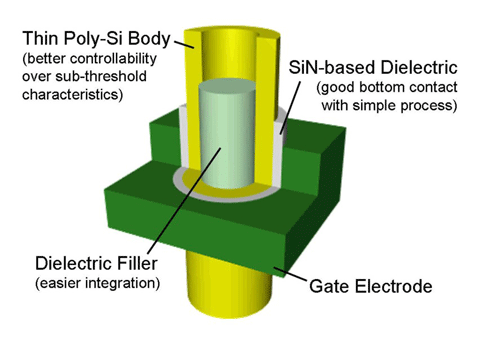 |
| 東芝の次世代NANDフラッシュメモリセル(講演番号17.2)の構造模式図(続き)。セルトランジスタの構造。食材のマカロニのような構造をしている。この図面は、IEDM実行委員会がプレス向けに配布した資料の一部 |
 |
 |
 |
| 新しい概念に基づく技術の講演 | 有機エレクトロニクスの注目講演例。東京大学による通信シート技術(講演番号9.3) | エネルギー収集デバイスの講演例 |
□IEDM 2007のホームページ(英文)
http://www.his.com/~iedm/
□関連記事
【12月10日】IEDM 2007前日レポート、次世代不揮発性メモリの本命争いが激化
http://pc.watch.impress.co.jp/docs/2007/1210/iedm01.htm
(2007年12月12日)
[Reported by 福田昭]
【PC Watchホームページ】
PC Watch編集部 pc-watch-info@impress.co.jp お問い合わせに対して、個別にご回答はいたしません。
Copyright (c)2007 Impress Watch Corporation, an Impress Group company. All rights reserved.