Samsung、容量4GBのDIMMを実現するDRAMスタック技術
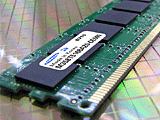 |
4月23日(現地時間) 発表
韓国Samsung Electronicsは23日(現地時間)、DRAMのダイを積層化することで大容量を実現する「TSV(Through Silicon Via)」技術を開発し、WSP(Wafer-level-processed Stacked Package)上で実現したと発表した。
現在、複数のダイを1パッケージにまとめたMCP(Multi-Chip Package)の場合、金属のワイヤーによってダイ同士を接続しているため、接続にはパッドに数百ミクロンの幅のスペースを用意する必要があり、パッケージが大型化していた。
新技術は、ダイ上にレーザーで開けられた数ミクロンサイズのホールに、銅を満たすことでダイ同士を接続し、ダイ横からの配線を不要にした。また、アルミニウムのパッドを内包し、再配線層を省いたことで、従来のワイヤー配線が起因するタイミングの遅延問題を解消。これによりパッケージの小型化と高速化、低消費電力化が可能になるという。
この技術を応用すれば、512MbitのDDR2を4層に配列させ、1チップで2Gbitの容量を実現可能。これにより容量4GBのDIMMが実現できるようになるとしている。また、現在のMCP技術では不可能とされていた1.6Gbps以上の転送速度を実現できるという。
同社は、2010年以降に予測される大容量化/高密度化システムに対して、同技術でサポートしていくとしている。
□Samsungのホームページ(英文)
http://www.samsung.com/
□ニュースリリース(英文)
http://www.samsung.com/PressCenter/PressRelease/PressRelease.asp?seq=20070423_0000340141
(2007年4月24日)
[Reported by ryu@impress.co.jp]
【PC Watchホームページ】
PC Watch編集部 pc-watch-info@impress.co.jp お問い合わせに対して、個別にご回答はいたしません。
Copyright (c)2007 Impress Watch Corporation, an Impress Group company. All rights reserved.
