 |


■元麻布春男の週刊PCホットライン■45nmへの移行を進めるIntelの製造施設 |
●IntelのFabの変遷
Intelは2月26日(現地時間)、ニューメキシコ州リオ・ランチョで稼働中のFab 11Xに10~15億ドルの追加投資を行ない、45nmプロセスに対応した製造施設としては同社4番目の工場に転換すると発表した。
現在、Intelはオレゴン州ヒルスボロのD1Dで、45nm製造プロセスの開発を行なっており、1月に45nmプロセスによる最初のx86プロセッサでOSの起動に成功したと発表したばかり。加えてアリゾナ州オコティッロにFab 32、イスラエルのラキッシュ-キリヤット・ガットにFab 28をそれぞれ建設中だ。Fab 11Xは45nmプロセスによる4番目の工場ということになる。
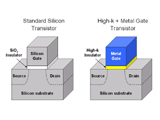 |
| 45nmプロセス(右)ではHigh-k(高誘電率)ゲート絶縁膜を採用 |
Intelはこの45nmプロセスから、トランジスタ素材に新しい材料を用いる。高誘電率(High-k)材料をゲート絶縁膜に、金属材料をゲート電極に用いることで、リーク電流を大幅に削減する。この段階で4番目の工場建設に着手したということで、この新材料による製造プロセスが極めて順調であることがうかがえる。
今回の投資額は10~15億ドルとされているが、これは工場を新設しているFab 32に対する投資額(30億ドル)の約半分。トランジスタ材料が変更されることに加え、投資額が大きいことから考えても、工場内部の主要な製造施設はほとんど入れ替えになるのではないかと思われる。
Fab 11Xが量産を開始したのは2002年10月で、Intelで最初の300mmウェハによる量産工場であると同時に、製造ラインが完全自動化された最初の工場でもあった。スタート時は130nmプロセスであったが、2003年後半に90nmプロセスへ移行、現在まで90nmプロセスでマイクロプロセッサの量産を行なっているとされている。Intelの90nmプロセス量産工場中、最大規模であったハズのFab 11Xが45nmプロセスへの転換工事に入るということから、同社のプロセッサの主力が65nmプロセスへの移行を完了しつつあると考えて良いだろう。
現在、65nmプロセスで量産を行なっているのは、アリゾナ州チャンドラーのFab 12と、アイルランド・リークスリップのFab 24/24-2の2カ所。さらにオレゴン州ヒルスボロのD1Cも65nmプロセスへ移行したとされているが、なぜかこの工場については、最近あまり言及されることがない。開発工場から量産工場へ切り替わったとされているものの、工場の名称が開発を示すDのままにされているなど、やや変則的だ(従来は、D1A -> Fab 15、D1B -> Fab 20など、量産工場になると同時に名称が改められていた)。あるいはUMPC用の低消費電力プロセッサ(同じ65nmプロセスでも低消費電力に特化したP1265を用いる)の量産等、若干異なる位置付けなのかもしれない。
| Fab名称 | 所在地 | 目的 | ウェハサイズ | 現時点での 最先端製造プロセス | 製造プロセス 移行予定 | クリーンルーム面積 |
|---|---|---|---|---|---|---|
| D1C | Hillsboro, Oregon | 量産用 | 300mm | 65nm | 150,000平方ft | |
| D1D | Hillsboro, Oregon | 開発用 | 300mm | 45nm(開発中) | 212,000平方ft | |
| Fab 11X | Rio Rancho, New Mexico | 量産用 | 300mm | 90nm | 2008年後半に45nm | 243,000平方ft |
| Fab 12 | Chandler, Arizona | 量産用 | 300mm | 65nm | 210,000平方ft | |
| Fab 24/24-2 | Leixlip, Ireland | 量産用 | 300mm | 65nm | 224,000平方ft | |
| Fab 28 | Lachish-Qiryat Gat, Israel | 量産用 | 300mm | 建設中 | 2007年内に45nm | 200,000平方ft |
| Fab 32 | Ocotillo, Arizona | 量産用 | 300mm | 建設中 | 2008年前半に45nm | 171,000平方ft |
上述したように45nmプロセスではトランジスタ材料が変更されるものの、露光技術(リソグラフィー)は従来通り波長193nmのフッ化アルゴンレーザーによるドライ露光を用いるとしている。2009年に実用化される次の32nmプロセスでは、当初IntelはEUV露光に切り替える意向を持っていた。しかしEUV露光は、光学系が反射光学系になるなど、大幅に変わることから開発が遅れており、Intelも32nmプロセスでの導入をほぼ断念している。
32nmプロセスについては、今のところ45nmプロセス技術で使われている193nmレーザーとフェイズシフトマスク技術の延長で対処するものと見られるが、インマーションリソグラフィー(液浸露光技術)の採用も否定していない。液浸露光技術は、レンズとウェハの間に屈折率の高い液体を挟むことで、レンズの開口率を高め、より微細な露光を可能にするもの。32nmプロセスにEUVを使うと表明していた時代、Intelは、液浸露光技術を「つなぎ」的なものとして否定的だったが、EUVの遅れでそうも言っていられなくなったのだろう。ただIntelはすでにEUV技術に多大の投資を行なっており、2011年の22nmプロセスではEUV露光を採用しようとするハズだ。
 |
| EUV露光器の解説 |
一方、プロセス技術開発のもう一方の雄であるIBMは、液浸露光技術の採用に積極的で、2008年に導入される45nmプロセスから利用するとも言われている。また、液浸露光技術の改良を続けることで、35nmプロセスや22nmプロセスの時代まで、まだ実証されていないEUV露光技術を採用しないで済むとしており、Intelと対照的だ。
それはともかく、この22nmプロセスの世代には、トランジスタ構造を3次元化するトライゲート・トランジスタ技術の採用も視野に入ってくるだろう。また、次世代の450mmウェハへの移行、という話も出てくるかもしれない。EUV露光機は、それだけでかなり高価だと言われており、その分のコストを補償できる技術が必要になるとも考えられるからだ。
こうした技術により、当面、ムーアの法則を維持することはどうやら可能らしい。18カ月~24カ月で1チップに集積可能なトランジスタ数を2倍にできるというムーアの法則は、半導体業界の成長の源であり、これが維持できなくなるということは、半導体業界の成長の限界にもつながる。それが当面は回避可能だというわけだが、今後、物理的な限界との戦いはいよいよ厳しくなるだろう。
と同時に、ムーアの法則により倍増したトランジスタをどうユーザーの価値に結びつけていくか、という問題との戦いも一層厳しさを増すものと思われる。現時点におけるその答がマルチコアでありメニーコアであるわけだが、こちらの戦いは必ずソフトウェアが立ちはだかる。物理法則とソフトウェアのどちらが真の強敵なのだろう。
□Intelのホームページ(英文)
http://www.intel.com/
□Fab 11X改修のリリース(和文)
http://www.intel.co.jp/jp/intel/pr/press2007/070227.htm
□関連記事
【2月27日】Intel、ニューメキシコのFab 11Xを45nm向けに改修
http://pc.watch.impress.co.jp/docs/2007/0227/intel.htm
【1月29日】Intel、45nmプロセスの次期CPU「Penryn」の試作に成功
http://pc.watch.impress.co.jp/docs/2007/0129/intel.htm
【1月29日】IBM、AMD・ソニー・東芝とHigh-k金属ゲート採用のトランジスタ技術を開発
http://pc.watch.impress.co.jp/docs/2007/0129/ibm.htm
(2007年3月1日)
[Reported by 元麻布春男]
【PC Watchホームページ】
PC Watch編集部 pc-watch-info@impress.co.jp ご質問に対して、個別にご回答はいたしません
Copyright (c) 2007 Impress Watch Corporation, an Impress Group company. All rights reserved.